为什么要用等离子去胶机去除光刻胶?
众所周知,光刻胶是半导体晶圆制造的核心材料。在晶圆制程中,光刻工艺约占整个晶圆制造成本的35%,耗时占整个晶圆工艺的40-50%,是半导体制造中最核心的工艺。

在光刻环节里有个不可或缺的步骤就是晶圆去胶,光刻胶在完成图形复制和传递作用后,晶圆表面剩余光刻胶需要通过去胶工艺进行完全清除。
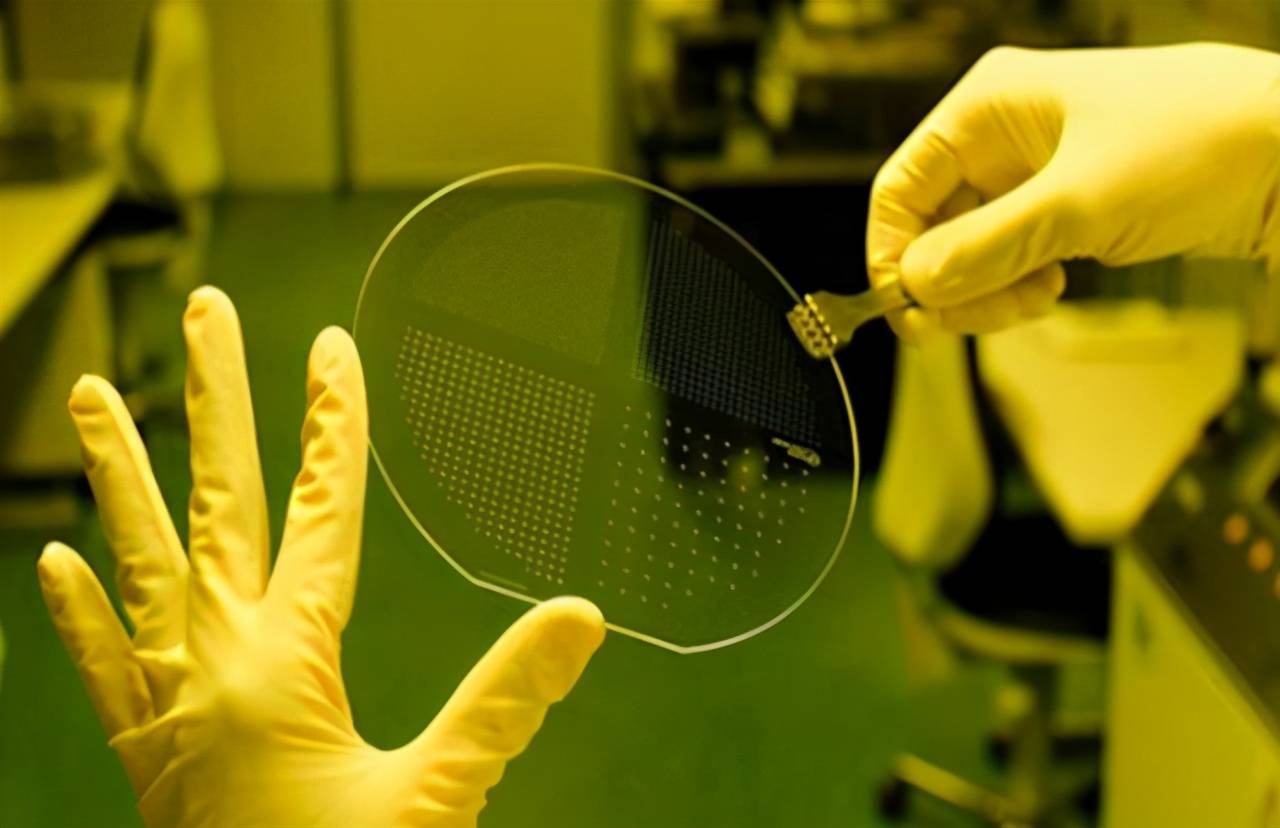
随着后摩尔定律时代的到来,半导体行业转向超浅结、多重图形化超低k介电和3D架构,对光刻胶去胶工艺要求也随之增高,需要更有效地处理复杂的器件结构。在晶体管层面,去胶工艺引起的薄膜微小变化就会影响结电阻率、结深和掺杂剂活化,从而影响器件的性能。
那么光刻胶如何去除呢?
半导体光刻胶去除工艺,一般分成两种,湿法去胶和干法去胶。相对于湿法去胶,等离子干法去胶利用高能等离子体处理光刻胶表面,去胶彻底且速度快,不需引入化学物质,减少了对晶圆材料的腐蚀和损伤,是现有去胶工艺中最好的方式。
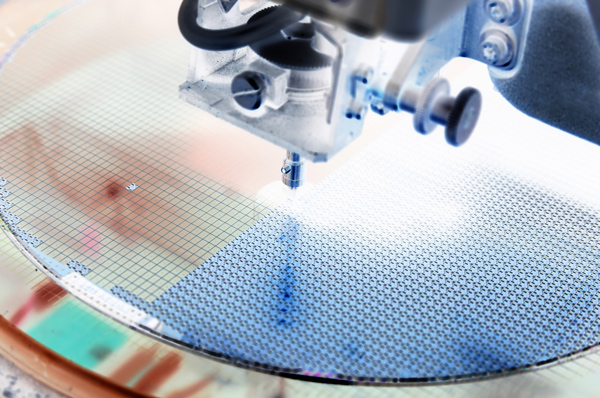
晟鼎旗下达因特PLASMA去胶机
晟鼎多年来坚持深耕等离子表面清洗活化,围绕半导体行业,晟鼎组建专业团队投入研发,迄今为止,获得了多项等离子晶圆去胶、刻蚀等专利。同时成立了苏州半导体设备有限公司,不断开拓晶圆领域的全新应用。

ICP等离子去胶机
ICP等离子去胶机依托晟鼎多年的光刻去胶的经验积累,采用高密度、低损伤等离子源设计,同时配备晟鼎成熟的远程ICP技术,达到高水平的去胶速率,并实现去胶损伤抑制;采用独立腔室结构设计,实现均匀的流场分布,去胶均匀性表现优异。

产品优势:
•兼容主流4-8寸圆形晶圆
•单次可处理两片晶圆,处理过程保持较低温度
•全自动程度高,实现全自动晶圆上下料、清洗流程
•等离子密度高,去胶效果好
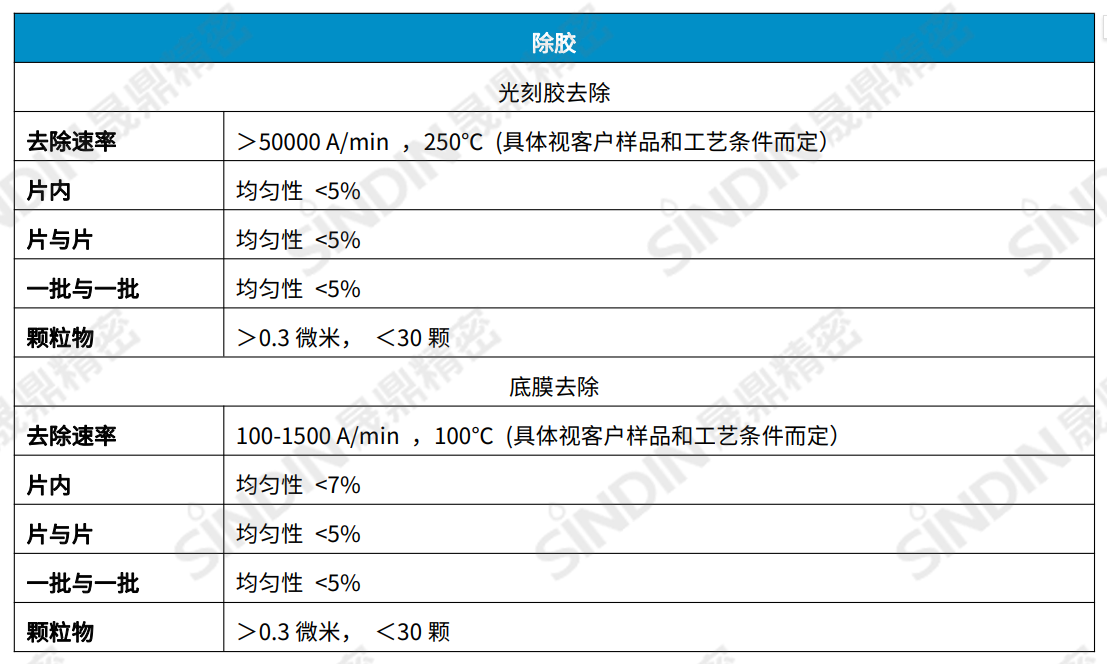
RIE等离子去胶机
RIE PLASMA去胶机是适用于硅基材料的晶圆表面去胶的清洗设备,也可用于光刻胶去除,碳化硅刻蚀,硬掩膜层干法清除,刻蚀后表面清洁,氧化硅或氮化硅刻蚀,DESCUM,介质与介质间光阻去除等应用领域,材料适用范围:4-8寸。设备稳定可靠、易于维护、产能高。

产品优势:
•高密度等离子体,各种工艺兼容性高
•清洗均匀性高,设备易于维护
•紧凑集成式设计、占地少
提升产品良率的专业解决方案
除了等离子去胶外,晟鼎作为等离子技术专家,在晶圆表面检测与晶圆封测段也有广泛的应用,致力为客户打造提升产品良率的专业解决方案。
